디지털 마이크로스코프를 이용한 BGA(범프)의 관찰·측정
5세대 이동 통신 시스템(5G)의 보급으로 반도체 디바이스의 미세화, 고집적화가 진행되어 제품의 검사 해석에 대한 니즈가 높아지고 있습니다.
여기에서는 디지털 마이크로스코프에 의한 관찰 사례가 많은 BGA(범프)의 관찰·측정 사례를 소개합니다.
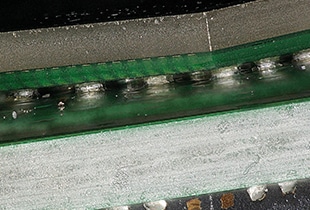
IC 패키지의 대표적인 종류
IC의 집적도가 높아지며 표면 실장형이 주류가 되었습니다. 또한 집적도가 높은 IC에는 매트릭스 타입(BGA 타입)의 패키지가 사용됩니다.
대표적인 IC 패키지의 종류는 아래와 같습니다.
표면 실장형: 논 리드 타입 패키지
- SON(Small Outline Non-leaded package)
-

표면 실장 패키지로 리드가 없고 대신 전극 패드가 접속용 단자로 준비되어 있습니다. SON은 2방향 타입으로 적은 핀 수를 위한 패키지입니다.
- QFN(Quad Flat Non-leaded package)
-

표면 실장 패키지로 리드가 없고 대신 전극 패드가 접속용 단자로 준비되어 있습니다. QFN은 4방향 타입의 패키지입니다.
표면 실장형: 매트릭스 타입 패키지
- BGA(Ball Grid Array)
-

구 형태의 땜납 볼을 패키지 바닥면에 어레이 형상으로 나열해 단자로 만든 제품입니다.
- PGA(Pin Grid Array)
-
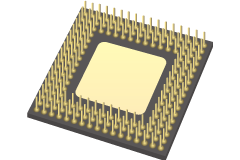
핀을 패키지 바닥면에 어레이 형상으로 나열해 단자로 만든 제품입니다.
- LGA(Land Grid Array)
-
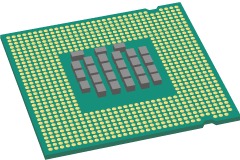
구리 등의 전극 패드를 패키지 바닥면에 어레이 형상으로 나열해 단자로 만든 제품입니다.
IC 칩을 실장하는 대표적인 접합 방법
- 와이어 본딩 접합
-
반도체 칩의 전극부와 리드 프레임이나 기판 상의 도체 사이를 금, 알루미늄, 구리 등의 가느다란 와이어로 접속하는 방법입니다.

- 플립 칩 접합
-
PCB에 IC 칩을 직접 접속하는 방법으로 FC-BGA(Flip Chip-BGA)라고 합니다. IC 칩의 전극 부분에 범프를 형성해 두고 PCB 측의 전극과 접속합니다. 와이어 본딩에 비해 공간을 절약할 수 있습니다.

- 왼쪽: IC 칩
- 오른쪽: 플립(페이스 다운)
플립 칩 접합 시 범프 형성 방법의 종류
- 땜납 볼 탑재법
- 사전에 구 형태로 성형된 땜납 볼을 전극 위에 탑재하고 리플로 처리로 범프를 형성합니다. 크림납 인쇄법으로 범프를 높일 수 있고, 땜납 볼의 치수를 일정하게 관리하여 범프의 높이 편차를 억제할 수 있습니다.
- 크림납 인쇄법
- 솔더 크림을 전극 위에 인쇄하고 리플로 처리로 범프를 형성합니다. 스루풋은 높지만 높이 편차를 억제하기 어려워집니다.
- 도금법
- 전해 도금으로 땜납 범프를 형성합니다. 범프를 세밀하게 형성할 수 있지만 스루풋이 낮아집니다.
디지털 마이크로스코프를 이용한 BGA(범프)의 관찰·측정 사례
KEYENCE의 4K 디지털 마이크로스코프 「VHX 시리즈」를 이용한 BGA(범프)의 최신 관찰·측정 화상 사례를 소개합니다.
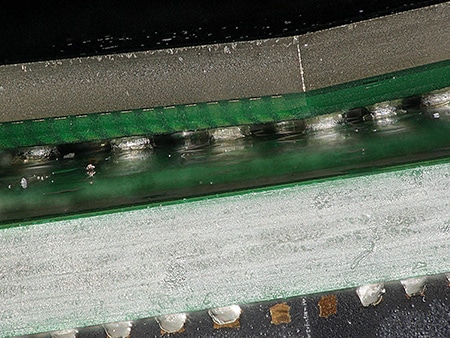
100× 링 조명
경사 관찰을 실시할 수 있어, 기판의 틈새를 통해 BGA 볼을 관찰할 수 있습니다.
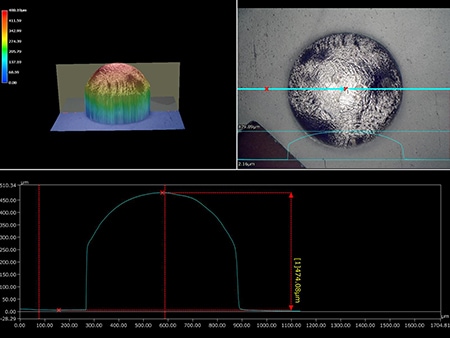
300× 믹스 조명(헐레이션 제거 화상)
믹스 조명과 헐레이션 제거 기능을 사용하여
헐레이션 없이 관찰할 수 있습니다.